LGA vs BGA : Guide d’ingénierie pour la sélection des paquets de puces
L’emballage des puces joue un rôle crucial dans la performance électrique, la gestion thermique, la fiabilité mécanique et la disponibilité du produit. Parmi les ensembles de semi-conducteurs modernes, Land Grid Array (LGA) et Ball Grid Array (BGA) sont deux technologies dominantes utilisées dans les processeurs, les systèmes embarqués, l’électronique mobile et les modules automobiles.
Cet article explique la structure d’ingénierie, le procédé d’assemblage, les caractéristiques électriques, les considérations de fiabilité et les applications concrètes des boîtiers LGA et BGA. Il fournit également des conseils pratiques aux concepteurs matériels sur la manière de sélectionner le boîtier approprié en fonction de l’intégrité du signal, des performances thermiques, des contraintes mécaniques et de la maintenabilité.
Table des matières
- [1. Introduction à l’emballage moderne des circuits intégrés] (#1-introduction-to-modern-ic-packaging)
- [2. Réseau de Grille Terrestre (LGA)](#2-Réseau de Grille Terrestre-LGA)
- 2.1 LGA Structural Design
- [2.2 Caractéristiques électriques et thermiques] (#22-caractéristiques-électriques et thermiques)
- 3. Réseau de Grille de Billes (BGA)
- 3.1 Conception structurelle BGA
- [3.2 Caractéristiques électriques et thermiques](#32-caractéristiques-électriques et thermiques)
- [4. Différences structurelles et électriques entre LGA et BGA] (#4-Différences structurales et électriques entre-LGA et BGA)
- [5. Fiabilité mécanique et comportement thermique] (#5-fiabilité-mécanique-et-comportement-thermique)
- [6. Méthodes d’assemblage, de soudure et d’inspection] (#6-assemblage-soudure-et-méthodes-inspection)
- 7. Scénarios d’application typiques
- [8. Hauteur du paquet et intégration système] (#8-hauteur-et-intégration-système)
- [9. Directives d’ingénierie pour choisir LGA ou BGA] (#9-conseils-d’ingénierie-pour-choisir-lga-ou-bga)
- 10. FAQ
- 11. Conclusion
1. Introduction à l’emballage moderne des circuits intégrés
L’emballage des circuits intégrés fournit trois fonctions essentielles d’ingénierie :
- Interconnexion électrique entre la puce en silicium et le circuit imprimé
- Protection mécanique de la puce semi-conductrice
- Chemin thermique pour la dissipation de la chaleur
À mesure que les circuits intégrés gagnent en complexité, les boîtiers traditionnels à plomb comme QFP peinent à supporter les hauts décomptes de broches, les signaux à haute vitesse et les configurations compactes exigés par l’électronique moderne.
Pour remédier à ces limitations, des technologies d’emballage de « réseau d’aires de zone » telles que le LGA et le BGA répartissent les connexions sur toute la partie inférieure de la puce, augmentant significativement la densité de connexion et améliorant les performances électriques.
2. Réseau de grille terrestre (LGA)
2.1 Conception structurelle LGA
Un boîtier Land Grid Array (LGA) utilise plateformes conductrices plates (terrains) disposées en grille sous le substrat du boîtier. Ces tampons sont connectés soit à :
- Broches de douille à ressort, ou
- Souder directement aux plaques de PCB.
Dans les systèmes de bureau et serveur, les broches sont situées dans le socket plutôt que sur le processeur, réduisant ainsi le risque d’endommager le processeur coûteux lors de la manipulation.
Une variante largement utilisée est Flip-Chip LGA (FCLGA). Dans cette architecture :
- La puce en silicium est retournée.
- Les micro-bosses de soudure relient la puce au substrat du boîtier.
- La chaleur se propage plus efficacement à travers l’arrière du coin.
Cette configuration réduit l'inductance d’interconnexion et la longueur du chemin du signal, améliorant ainsi les performances à haute vitesse.
Éléments structurels clés
- Substrat organique en encapsulé
- Couches de redistribution du cuivre
- Terres de contact plaquées nickel-or
- Diffuseur de chaleur intégré en option (IHS)
2.2 Caractéristiques électriques et thermiques
Les packages LGA offrent plusieurs avantages électriques :
Contacts à faible inductance
Des chemins de signal plus courts réduisent l’inductance parasite, ce qui est bénéfique pour les interfaces haute fréquence telles que les bus PCIe et mémoire.
Capacité de courant élevé
Les grandes plaques de contact permettent de meilleurs réseaux de distribution d’énergie (PDN), permettant aux processeurs modernes de consommer plus de 200 A de courant transitoire.
Performance thermique
La chaleur est transférée directement depuis la puce → le dissipateur → le dissipateur, offrant une excellente capacité de refroidissement dans les systèmes serveurs.
3. Réseau de Grille de Boule (BGA)
3.1 Conception structurelle BGA
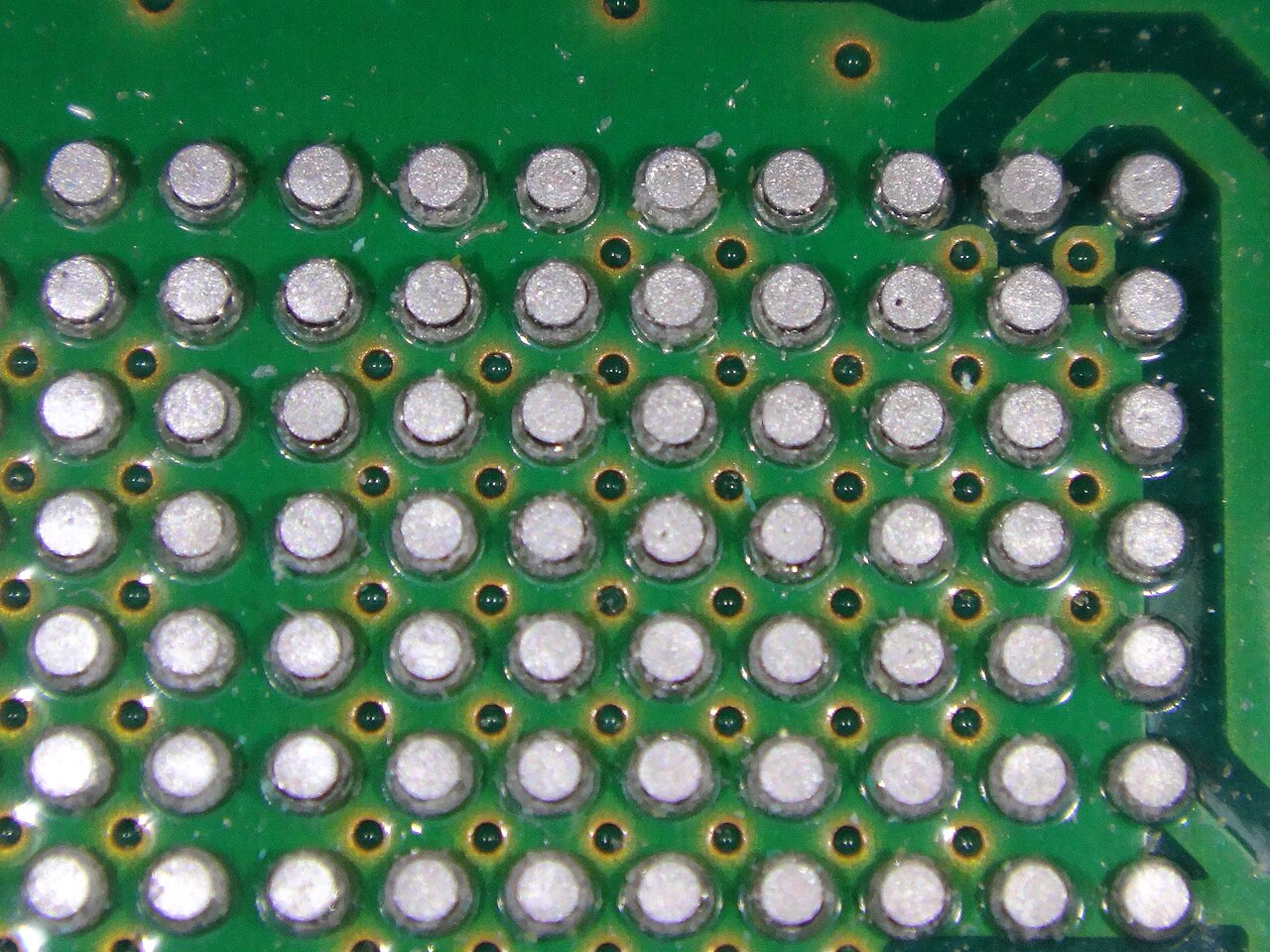
Un boîtier Ball Grid Array (BGA) utilise un réseau de boules de soudure sous l’appareil comme connexions électriques.
Lors de la fabrication :
- De la pâte à souder est appliquée sur les plaques de circuit imprimé
- L’appareil BGA est placé à l’aide d’un équipement pick-and-place
- La planche passe par un four à reflux
- Les billes de soudure fondent et forment des joints permanents
Parce que les connexions sont situées sous le boîtier, BGA supporte une densité d’E/S bien plus élevée que les boîtiers plombés.
Structure interne du paquet
Les couches typiques de BGA incluent :
- Puce en silicium
- Fils de liaison ou bosses à puce flip-chip
- Substrat stratifié organique
- Masque de soudure
- Réseau de billes de soudure
3.2 Caractéristiques électriques et thermiques
BGA offre plusieurs avantages en termes de performance :
Densité de connexion élevée
Des milliers de connexions d’E/S peuvent être intégrées dans une empreinte compacte.
Excellente intégrité du signal
Des interconnexions verticales plus courtes réduisent les discontinuités d’impédance et les interférences électromagnétiques.
Meilleure conduction thermique
La chaleur peut se dissiper à la fois par le dessus du boîtier et par la boule de soudure dans le circuit imprimé.
Ces caractéristiques rendent BGA idéal pour les processeurs mobiles, GPU et mémoire haute vitesse.
4. Différences structurelles et électriques entre LGA et BGA
| Caractéristiques | LGA | BGA |
|---|---|---|
| Type de contact | Plaques plates | Boulettes de soudure |
| Méthode d’attachement | Douille ou soudure | Soudure par refusion |
| Remplaçabilité | Remplaçable une fois pris | Permanent |
| Densité du signal | Haut | Très haut |
| Difficulté de réparation | Modéré | Haut |
| Inspection | Visual + Rayons X | Principalement des rayons X |
La différence fondamentale est que LGA sépare le contact électrique de la soudure, tandis que BGA les intègre dans une seule structure à billes de soudure.
5. Fiabilité mécanique et comportement thermique
.jpg)
La fiabilité mécanique dépend fortement du cycle thermique et du stress mécanique.
Considérations de fiabilité BGA
Les soudures BGA sont exposées à un décalage thermique entre :
- Puce en silicium
- substrat de paquet
- Matériau de PCB
Des cycles de température répétés peuvent provoquer des fissures par fatigue de la soudure.
Pour atténuer cela, les concepteurs utilisent souvent :
- Matériaux de remplissage
- Plamés PCB à haute Tg
- Compositions optimisées d’alliages de soudure
Considérations de fiabilité LGA
Les prises LGA évitent la fatigue de soudure car la connexion est mécanique plutôt que métallurgique. Cependant, ils introduisent d’autres risques :
- Broches de douille tordues
- Variation de la résistance de contact
- Fiabilité réduite dans des environnements à forte vibration
Ainsi, les sockets LGA sont généralement utilisés dans des environnements contrôlés tels que les serveurs et les ordinateurs de bureau.
6. Méthodes d’assemblage, de soudure et d’inspection

Les procédés de fabrication diffèrent considérablement entre les deux emballages.
Assemblée LGA
Deux approches existent :
LGA à socket
- CPU inséré dans le socket
- La plaque de charge sécurise la pression de contact
- Permet le remplacement sur le champ
LGA à soudure directe
- Pâte à souder appliquée sur les plaques de PCB
- Refusion de boîtier soudée similaire à QFN
Assemblée BGA
Les packages BGA nécessitent des processus SMT précis :
- impression par pochoir
- alignement pick-and-place
- profilage de la température de reflux
L’inspection comprend généralement :
- Inspection optique automatisée (AOI)
- Inspection aux rayons X
Parce que les soudures sont cachées sous le boîtier.
7. Scénarios d’application typiques
Applications LGA
- Processeurs de bureau
- CPU de serveurs d’entreprise
- Postes de travail haut de gamme
- Équipements réseau
Ces systèmes bénéficient de la disponibilité et de la capacité de mise à niveau.
Applications BGA
- Smartphones
- Tablettes
- GPU
- DRAM et mémoire flash
- Centrales électriques automobiles
- Modules de calcul embarqués
Ces systèmes privilégient la conception compacte et une forte intégration**.
8. Hauteur du boîtier et intégration système
| Catégorie | LGA | BGA |
|---|---|---|
| Hauteur des composants | Modéré | Low |
| Impact de douille | Ajoute 3 à 6 mm | Aucun |
| Densité des circuits imprimés | Moyen | Haut |
| Profil de l’appareil | Plus grand | Très compact |
Pour les appareils ultra-fins, BGA est généralement la seule option pratique.
9. Directives d’ingénierie pour choisir LGA ou BGA
Les concepteurs de matériel évaluent généralement quatre facteurs :
1. Disponibilité opérationnelle
Si le processeur doit être remplaçable ou évolutif, choisissez LGA.
2. Espace sur la carte
Pour les configurations de PCB compactes, BGA offre une densité d’E/S supérieure.
3. Gestion thermique
Les processeurs à haute puissance utilisent souvent du LGA avec de grands dissipateurs de chaleur.
4. Complexité de fabrication
BGA nécessite une capacité de contrôle de procédé et d’inspection SMT plus avancée.
10. FAQ
Pourquoi les ordinateurs portables utilisent-ils généralement des processeurs BGA ?
Les ordinateurs portables privilégient des formats finis et des configurations compactes de PCB, ce que les packages BGA permettent en éliminant les sockets.
Les puces BGA sont-elles impossibles à remplacer ?
Non. Ils peuvent être remplacés par stations de retravail BGA, mais le procédé nécessite un équipement spécialisé et des techniciens qualifiés.
Pourquoi les CPU de bureau utilisent-ils encore LGA ?
Les systèmes de bureau valorisent la capacité à évoluer et la facilité de maintenance, permettant aux utilisateurs de remplacer les processeurs sans soudure.
Quel paquet offre une meilleure intégrité du signal ?
Les deux peuvent bien performer. Cependant, BGA offre souvent des chemins de signal plus courts, ce qui est avantageux pour les interfaces à très haute vitesse.
11. Conclusion
LGA et BGA représentent deux stratégies d’emballage matures mais fondamentalement différentes.
- LGA privilégie la disponibilité opérationnelle, la puissance et le refroidissement haute performance.
- BGA se concentre sur miniaturisation, densité d’intégration et efficacité de fabrication.
Comprendre leurs différences structurelles, leurs exigences d’assemblage et leurs caractéristiques de fiabilité permet aux ingénieurs de choisir le package le plus approprié pour leur architecture système, contraintes mécaniques et exigences du cycle de vie.




